塑封器件需要做哪些可靠性试验?
作者:
网络
编辑:
瑞凯仪器
来源:
网络
发布日期: 2021.07.29
1、引言
塑封是目前广泛被使用的器件封装形式,是一种非密封性封装,其主要特点是重量轻、尺寸小、成本低,但散热差、易吸潮。随着塑封器件尤其是塑封微电路越来越广泛的应用,塑封微电路在军用领域的应用也逐步增多。对于塑封器件可靠性,应在满足常规可靠性试验要求的基础上,针对塑封特点和一些可能的失效模式、失效机理,进行一些特殊的试验。
本文介绍了塑封器件可靠性与试验方法,包括:
●湿度敏感度试验
●温度循环
●湿度偏置试验HAST试验
●高压蒸煮试验
2、标准
美国EIA(Electronic industries Association)和JEDEC(Joint
Electron Device EngineeringCouncil)针对塑封器件的可靠性及相关试验要求制定了相应的标准,如图1。对于所有的塑封器件均要满足JESD47标准要求,JESD47包括一些一般试验要求(如环境应力试验、电应力试验、非破坏性物理试验和破坏性物理试验等)、特殊试验要求(ESD、Latch-up等)、磨损可靠性试验要求(电迁移EM、与时间有关的击穿TDDB、热载流子注入HCI等)和可燃性试验要求,根据器件封装特点及可靠性要求可适当选择试验方法。尤其是对一种新技术、新工艺或新产品时。
J-STD-020A湿度敏感度试验对表贴器件湿度敏感度进行等级评定,其它儿个标准则具体针对温循、稳态温湿度寿命试验、高加速应力试验(HAST)、高压蒸煮等试验提供试验方法。
3.湿度敏感度等级评价
湿度敏感度是塑封表面贴装(SMDs)器件的一个重要指标。当塑封器件吸收了潮气后,在回流焊高温工艺中潮气迅速被汽化体积膨胀,从而造成封装分层、内部裂纹、键合损伤、引线断、芯片位移、钝化层裂纹等,甚至封装内发出爆裂的声响,就是常说的“爆米花”效应。
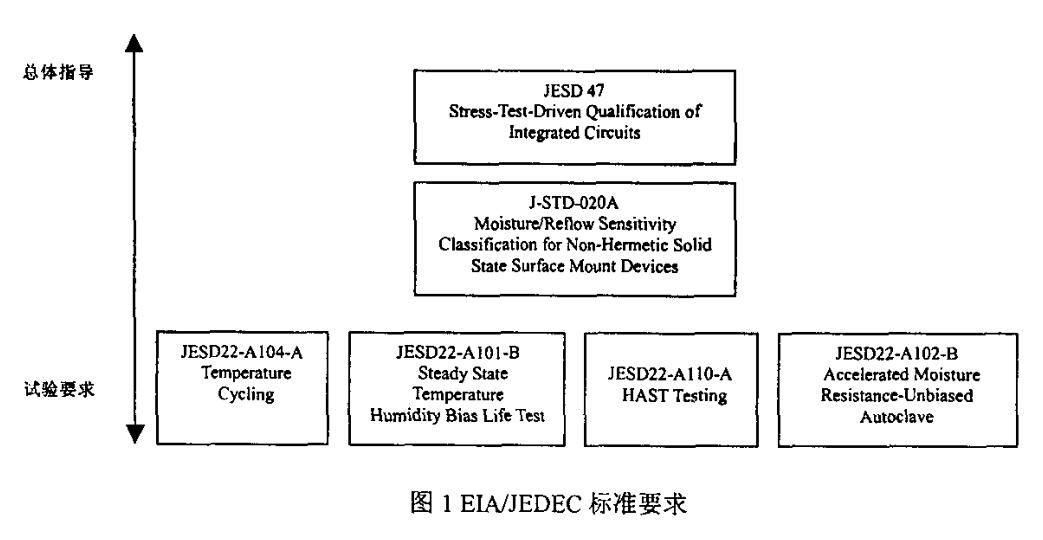
湿度敏感度等级评价试验是为了定级器件对湿度应力的敏感性,试验后器件的外包封上被打上相应的敏感度等级,根据器件湿度敏感度等级,在器件包装、储存、运输、传递、装配过程都应采取相应的措施,避免引入损伤。湿度敏感度等级决定了器件可以暴露在潮湿中的时间。
湿度敏感度试验适用于所有的表面贴装器件,包括 PBGAs、SOICs、PLCCs、TQFPs、PQFPs、RQFPs、TSOPs、soJs等。
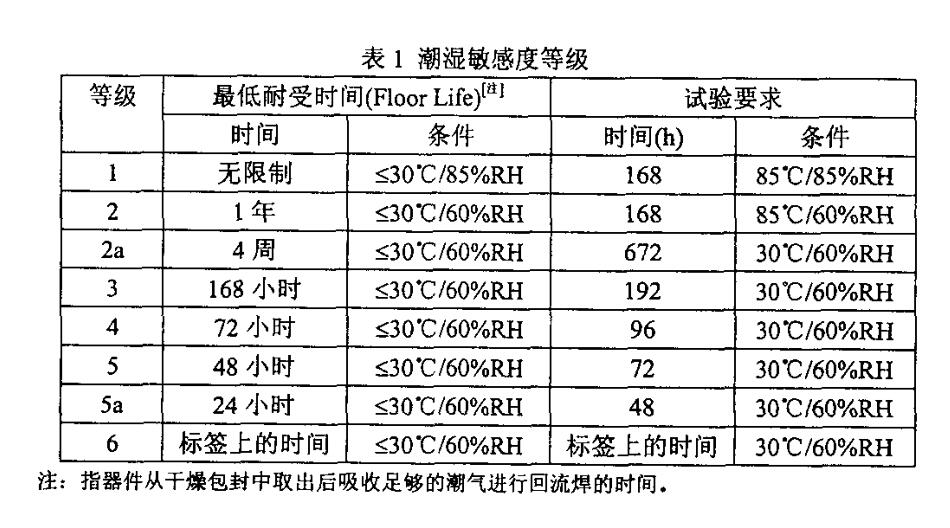
为了进行湿度敏感度等级评价,Altera推荐采用100%对流回流系统以满足J-STD-020A标准所要求的回流焊剖面。
在试验中,对于小、薄尺寸器件,由于回流过程中为了满足大器件回流要求,小器件体温度将超过220℃以上的温度,为了补偿这一差异,小尺寸封装器件要求耐受235℃温度。表2给出小尺寸器件回流条件。
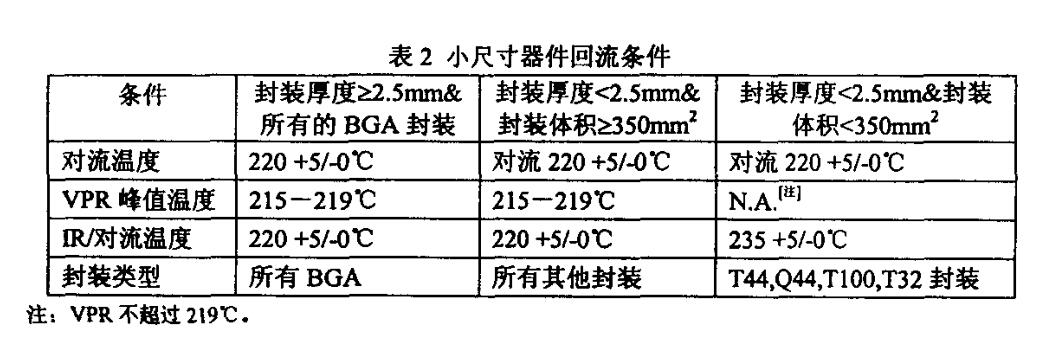
试验过程中器件达到试验温度的速率也会影响封装可靠性,表3给出两种典型的对流回流技术(完全对流和R对流)的回流剖面。

如果器件通过Ⅰ级湿度敏感度试验,那么可以认为该器件是非湿度敏感性器件,不需要干燥包装。如果器件仅仅通过6级湿度敏感度试验,说明该器件是极度湿度敏感器件,仅仅干燥包装不足以提供应有的保护,必须在装配前采取烘焙等措施。
4、温度循环试验
温度循环试验主要是考察塑封器件对高低温的耐受能力。试验后器件不应有明显的损伤,如裂纹、碎裂或断裂。表4给出温度循环试验等级。
温度循环试验还可以暴露由不同材料组成的封装的缺陷。器件的封装包含有不同的材料,当封装经历不同的极限温度时,由于其温度系数存在差异膨胀和收缩的速率各不相同,图2给出了图⒉给出不同温度系数材料受热膨胀的差异。当两种材料紧密接触时,膨胀表现为两种材料膨胀的合成,即两种材料扩展了同样的长度,对材料1来说引入了额外的应力。当材料经受低温收缩时情况也一样。这样在材料的接触部位就会产生剪应力,当器件快速进行高低温冲击时,接触部位的剪应力有压应力到张应力往复变化,如果温度极限应力足够强,材料就会发生裂纹或位移,从而造成器件金属引线和金属化层发生位移。如图3。

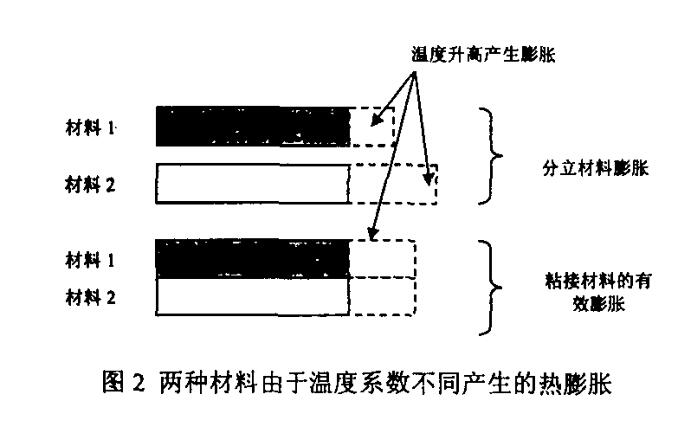

这种剪应力集中的地方在芯片的四角上,尤其是面积比较大的芯片更要注意。封装的裂缝会向下延伸到器件,以至于造成钝化层下面的金属化层和多晶硅层断裂。金属引线的位移会造成漏洞甚至短路。
为了避免这种失效的发生,应按JESD22-A 104-A,对照表4分级对器件进行温度循环试验考察。
5、湿度偏置试验
评价器件在潮湿环境下的可靠性可以进行稳态温度湿度偏置寿命试验(JESD22A-101-B),该试验方法采用温度、湿度和电应力来加速潮气进入器件封装。试验在85℃和
85%RH条件下进行。这种试验方法不能暴露器件封装组合材料或封装装配缺陷。
试验在高低温交变湿热试验箱中进行以提供适当的温度和相对湿度,同时还要提供必要的电连接以实现加偏置。试验是在极限应力条件下进行。
在试验中采用两种偏置方式:连续偏置和周期性偏置。
连续偏置下直流偏置被连续地加到器件上。当器件温度高于腔体环境温度10℃以内,或当器件耗散功率低于200mW,连续偏置比周期性偏置更严酷。当器件的耗散功率高于200mW,必须重新计算芯片的温度,即功率×热阻,如果计算出来的结果高于试验规范5℃以上,则应采用周期性偏置。
对于周期性偏置,直流电压以一定的频率和占空比被间歇地加到器件上。对于一个特定器件如果偏置引入的温升高于腔体环境温度10℃以上,周期性偏置比连续偏置更严酷。在周期性偏置电关断期间潮气聚积在芯片上。对于多数器件来说周期性偏置通常采用1小时通1小时断的方式。
6、HAST 试验
同样采用高加速应力试验(HAST)来评价器件在潮湿环境下的可靠性(JESD22-A110-A)。与湿度偏置试验相同,HAST试验箱也采用电应力、高温和高湿应力的组合应力形式,加速退化失效。在偏置应力下试验的环境条件是130℃和85%RH。HAST试验能够揭示封装材料、密封性以及封装材料与引线之间的缺陷。
HAST中的电应力同湿度偏置试验的一样,但Vcc采用条件。由于HAST试验腔体条件很严酷,试验用的老化板必须经过特殊设计。
7、高压蒸煮试验
高压蒸煮试验是评价非密封器件抗潮湿能力的一种加速应力试验,试验应力采用较严酷的气压、湿度和温度——PCT试验箱,来加剧潮气从外部通过封装材料、金属引脚边缘进入芯片表面。JESD22-A102-B对试验进行了详细的规定。
试验条件如表5。

高压蒸煮试验主要暴露器件相关的四类失效:
其一、焊盘、金属化腐蚀性失效。高压蒸煮试验中高气压将水蒸气通过封装压到器件中,直至器件表面,对于键合焊盘和钝化层有缺陷的金属化层将产生腐蚀作用。
其二,浮栅漏电失效。对于一些非挥发性器件如闪存和EEPROM,在浮栅存有电荷,如果潮气通过钝化层到达浮栅,很快就会将浮栅上存储的电荷泄漏掉,造成器件失效。
其三,铅锡迁移导致漏电失效。器件在封装工艺中清洗失当,在潮热环境下铅锡会生长出数状须来,造成引线之间漏电甚至短路。
其四,封装外部损伤。
8、结论
利用上述试验考核、评价塑封器件的可靠性,并通过持续改进封装可靠性和降低现场使用失效率,从而保证终用户的产品可靠性需求。上述试验方法都是极限应力条件下的加速退化试验,目的是揭示设计和工艺引入的缺陷,以及塑封器件可能发生的退化机理。这些信息对于塑封器件的传递、装配、分类和储存都具有指导作用。
作者:恩云飞
信息产业部电子第五研究所
来源网络
如有侵权,请告知,我们立即删除,谢谢!