热门关键词: 高低温试验箱 恒温恒湿试验箱 步入式恒温恒湿实验室 高压加速老化试验箱 冷热冲击试验箱
目前,国内外对于IGBT器件失效的研究众多,主要从两方面入手,一方面是考虑器件自身的工作循环,另一方面是考虑器件的实际工况环境,研究表明IGBT失效是由内部工作循环及外部工况同时作用导致的,其失效机理复杂,失效模式主要分为封装类失效及芯片类失效,如图2-2所示。
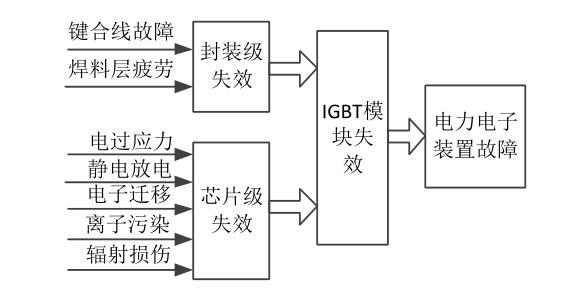
键合引线一般是通过超声波键合工艺,实现与芯片、DBC板的连接,由于工作过程中承受较大的电流负载,其键合点处为IGBT模块的薄弱环节之一。键合线故障主要包括键合点脱落及键合线断裂,研究表明功率电子器件中键合线失效占器件总失效的70%左右。随着技术发展,用于IGBT键合线的材料特性越来越好,键合线断裂情况很少再发生,因此IGBT键合线故障主要的失效模式为键合点脱落。键合线脱落如图(a)、(b),由于铝键合线的抗拉极限低,在IGBT正常工作时的功率循环与温度循环下,因电流通过产生的热应力及材料间CTE差异引起的剪切应力,导致键合线与芯片连接处萌生裂纹,在持续的热应力或外部环境如振动冲击影响下,裂纹扩展,进而导致IGBT键合线脱落。
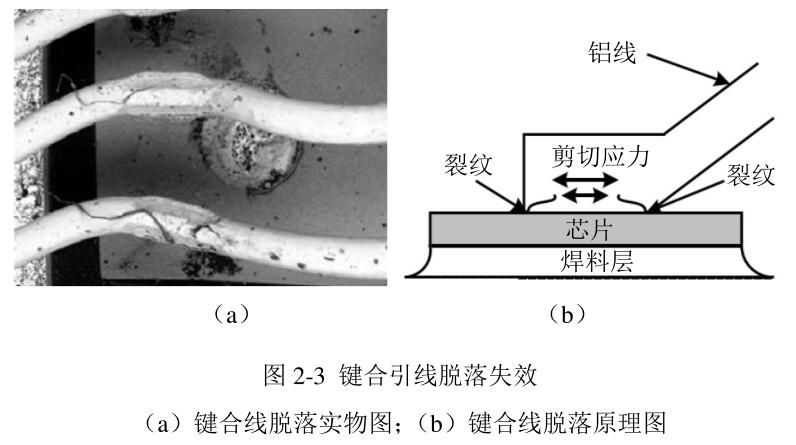
键合引线在剪切应力作用下裂纹扩展失效的过程如图2-4 所示,可以看到裂纹萌生的部位产生了应力集中效应,导致靠近裂纹位置的应力(σlocal) 要明显大于其它距离裂纹位置较远的应力(σ),两应力之间存在如式(2-1)所述关系式。图2-4中: a表示当前形成的裂纹长度,r 表示到当前形成裂纹尖部的距离大小。可以看到,σloca 应力随着到裂纹尖部的距离增大而呈现减小趋势,当某一靠近裂纹的位置出现σloca应力大于铝键合引线产生的应力时,裂纹变形将发生扩展,进而导致铝键合引线与IGBT 芯片间发生脱落。同时,如果需要确定裂纹变形区域的宽度,我们可以在式(2-1) 和式(2-2) 中假定σloca=σy,,然后求解即可。

焊料层主要作用在于连接IGBT器件内部各层材料,在工作期间产生的热循环过程中,由于材料间CTE差异,在材料间产生交变的剪切热应力,焊料层疲劳如图2-5 (a)、 2-5 (b)所示。在上述应力的连续作用下,导致焊料层疲劳老化,萌生裂纹,进而扩展至材料分层,同时由于裂纹及分层的产生,焊料层与各层材料间的接触面积变小,模块热阻增大,IGBT 器件内温度进一步升高,并加速焊料层的失效,循环往复,致使IGBT过热烧毁。另一方面,不可避免的IGBT在制造过程中由于其工艺本身缺陷,其初始状态就具有裂纹或空洞等,这些工艺缺陷在热应力的激发下,同样将导致器件的失效。
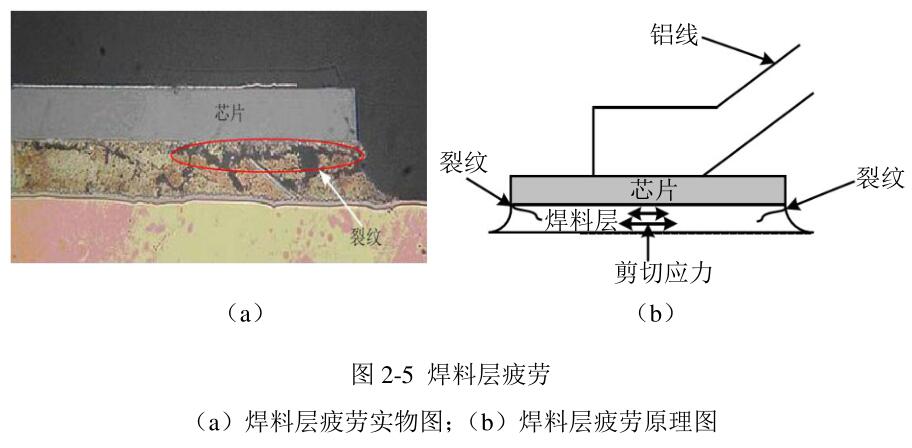
IGBT器件焊料层疲劳的扩展过程与键合引线裂纹扩展类似,如图2-6所示。上图所示热剪切应力作用下,焊料层疲劳裂纹末端产生一个不可恢复区域,同时在热应力作用下,裂纹发生拉长,致使焊料层生成一个包含可恢复变形( △ael )和永久变形( △apl )新的表面。在应力σ去除后,前面形成的可恢复变形将复原,但永久变形部分仍在,致使新生成的表面发生扩展。

400电话