热门关键词: 高低温试验箱 恒温恒湿试验箱 步入式恒温恒湿实验室 高压加速老化试验箱 冷热冲击试验箱
又称MRT,是用来模拟芯片从运输到上板的整个流程(图5-1)。

T&H的条件分为6级,用来模拟芯片在生产过程中环境温度和湿度,通常我们使用Level3 (表5-1)。

IR Reflow的条件是在在240度的烘箱内过三遍,用来模拟芯片在做SMD时的状况(图5-2)。

SAM也叫SAT,是用超声波来做断层扫描的一种检测方法,利用超声波在不同表面会造成反射的原理(图5-3),可以检测到材料中的不同材料之间断层等等,在BGA封装中可以检测银浆空洞(EpoxyVoid),环氧树脂空洞(MoldVoid),树脂与芯片之间的断层( Delamination)等等。
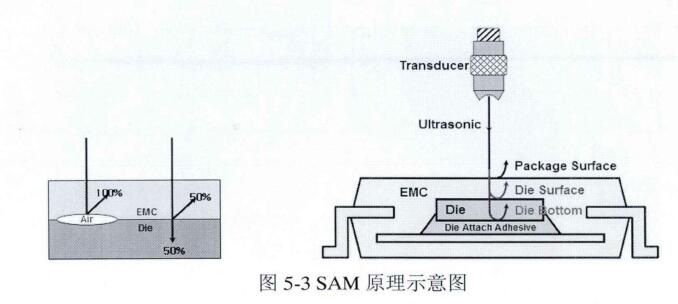
1)A SCAN:由于材料之间会发生反射,将示波器的到反射的波形来和正常波形进行对比,来判断在什么位置发生问题(图5-4)。

3)T SCAN:与A SCAN相反,T SCAN利用另一个探头接受穿透后的超声波,转化成电信号来分析(图5-5)。

C SCAN是精确的空洞,断层等缺陷的分析方法。
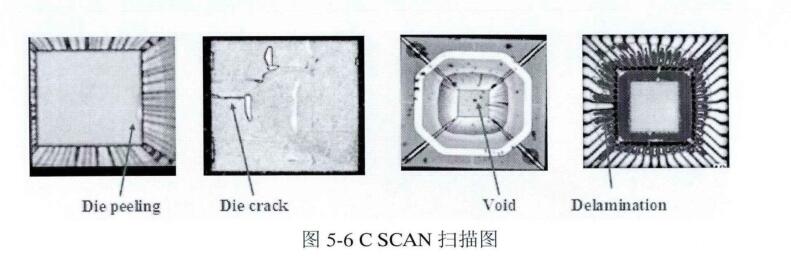
耐久性实验既是芯片的老化试验,浴盆曲线代表了半导体器件的失效分布和时间的关系,48小时内的前期失效是属于潜在的质量问题,在48小时到106小时内是失效率相对较低的,106 小时后属于老化失效(图5-7)。所以,根据芯片的不同用途,耐久性实验也分为不同的级别,如下图:

对于不同的芯片封装结构,用途等考量,试验者会选取具有针对性的可靠性测试的项目,我们此次只是金线更换铜线的线材更换试验,所以根据查阅公司规范文件,需要做的可靠性测试是MRT,TC和HTS,可选项HAST,如下表5-1:

3) 1000 Cycle
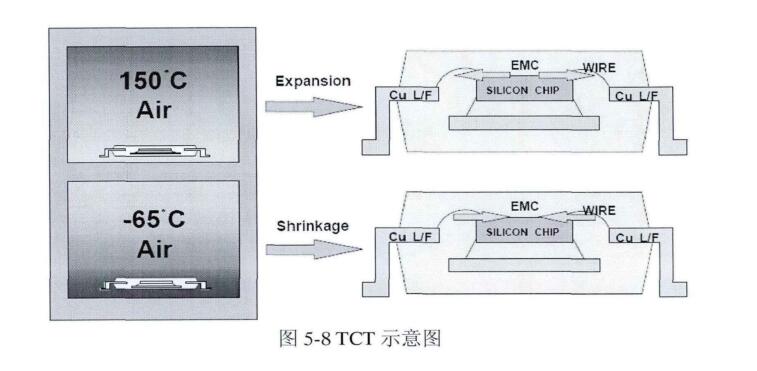
1) Open 的失效来源于EMC与芯片表面分层导致的焊球脱离或焊线断裂(图5-9)。
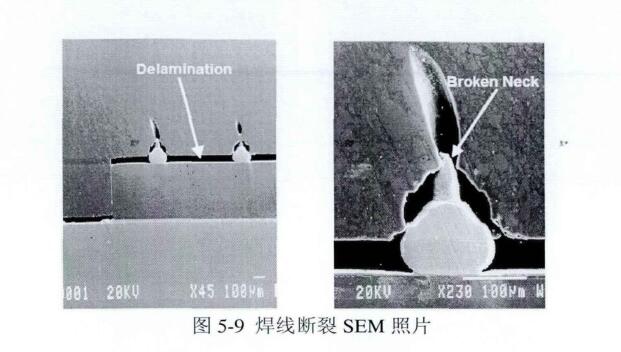
2) Short 的失效来源于Chip Crack (图5-10)。

半导体器件持续运行的问题很高,高温会加速一些材料间的分子级别的扩散,主要集中在焊球和焊盘之间,由于扩散速度不同的加速,导致产生Kirkendall空洞,严重者会造成焊点分离(图5-11)。
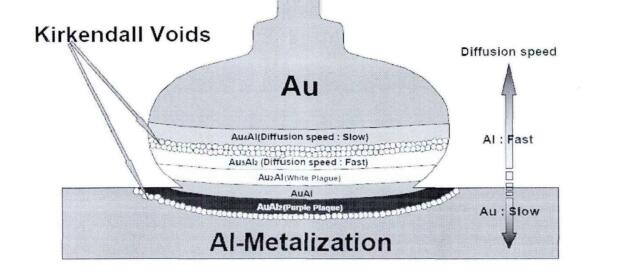
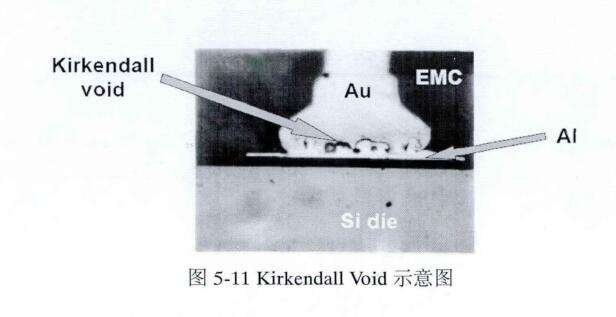
1) Open 主要是潮气对焊盘的腐蚀,造成了虚焊(图5-12)。
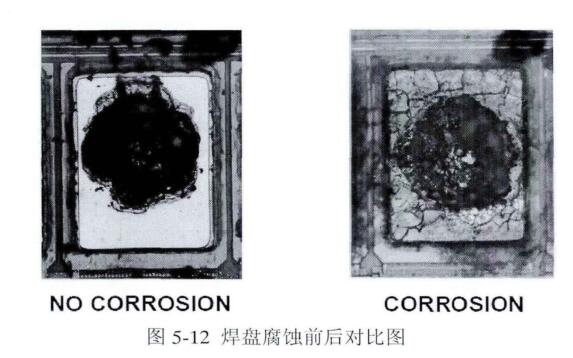
2) Short 主要是由于潮气的渗入,造成了EMC内部有漏电(图5-13)。

芯片测试数量的选取按照客户对于芯片可靠性等级的要求来确定,通常是SQB评估(Qual Level B),所以必须设置3个实验组,每个实验组的数量是22+3x77=253 (表5-2)。

MRT的条件如下表5-3:
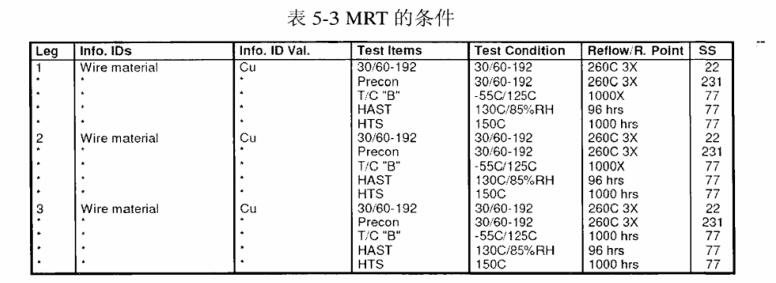
Long Term的条件如下表5-4:

400电话